Gã khổng lồ sản xuất chip TSMC đã gây chú ý khi công bố khoản đầu tư kỷ lục 100 tỷ USD vào một nhà máy sản xuất bán dẫn tại Arizona, Mỹ, hồi tháng 3. Tuy nhiên, điều khiến dự án này trở nên đặc biệt không chỉ là quy mô vốn, mà còn là công nghệ đóng gói tiên tiến CoWoS mà TSMC dự định mang đến.
Công nghệ CoWoS, vốn quen thuộc ở Đài Loan đến mức CEO AMD Lisa Su từng nhận xét hòn đảo này là “nơi duy nhất bạn có thể nói CoWoS và mọi người đều hiểu”, đang trở thành yếu tố then chốt trong ngành công nghiệp chip AI. TSMC hiện là nhà cung cấp duy nhất có khả năng cung cấp giải pháp CoWoS trọn gói, tạo ra một “điểm nghẽn” tương tự như vai trò độc quyền của ASML trong việc cung cấp máy quang khắc EUV.
Giờ đây, với việc xây dựng tổ hợp nhà máy sản xuất chip trị giá hàng tỷ đô la ở Arizona, TSMC đang mang công nghệ CoWoS đến một chân trời mới.
CEO Nvidia Jensen Huang nhấn mạnh tầm quan trọng của đóng gói tiên tiến cho chip AI tại sự kiện Computex 2025 ở Đài Loan: “Chúng ta cần có công nghệ và quy trình cực kỳ phức tạp để ghép nhiều chip lại thành một chip khổng lồ”.
Đóng gói là một công đoạn quan trọng trong quy trình sản xuất chip bán dẫn. Trong phương pháp truyền thống, các thành phần chip được “niêm phong” bên trong lớp vỏ bảo vệ. Các chip riêng lẻ như GPU, CPU, HBM… được sản xuất riêng rẽ, sau đó gắn trên bo mạch và kết nối thông qua hệ thống truyền dẫn.
Đóng gói tiên tiến là một kỹ thuật phức tạp hơn, cho phép tích hợp nhiều chip hơn vào một “gói”. Bằng cách đặt chúng gần nhau, hiệu suất tổng thể được cải thiện, tốc độ truyền dữ liệu tăng lên và mức tiêu thụ năng lượng giảm xuống.
Để dễ hình dung, có thể xem đóng gói tiên tiến giống như cách bố trí các phòng ban trong một công ty. Khi các phòng ban càng gần nhau, nhân viên càng tiết kiệm thời gian di chuyển, giúp việc trao đổi và phối hợp diễn ra nhanh chóng và hiệu quả hơn.
Theo Dan Nystedt, Phó chủ tịch công ty đầu tư tư nhân TrioOrient, công nghệ đóng gói tiên tiến đã trở nên cực kỳ quan trọng trong bối cảnh bùng nổ của AI. Các ứng dụng AI đòi hỏi khả năng tính toán phức tạp, giảm thiểu tối đa độ trễ và lỗi, và công nghệ mới này giúp tăng tốc hiệu suất của chip.
CoWoS hiện là công nghệ đóng gói tiên tiến nhất, được sử dụng để sản xuất chip AI của cả Nvidia và AMD. Nystedt nhận xét: “Hầu như bất kỳ ai thiết kế chip AI và đặt hàng TSMC sản xuất đều sử dụng CoWoS”.
CoWoS kết hợp nhiều thành phần của một hệ thống trên một chip (SoC) để tăng hiệu suất và khả năng xử lý. Tên gọi CoWoS là viết tắt của Chip-on-Wafer (CoW) và Wafer-on-Substrate (WoS). CoW đề cập đến việc xếp chồng chip lên tấm wafer, còn WoS là gắn wafer vào đế mạch, giúp giảm không gian chip, tăng hiệu suất và hạ chi phí.
Mặc dù nổi lên trong làn sóng chip AI, CoWoS đã tồn tại hơn 15 năm. Đây là thành quả của nhóm kỹ sư do Chiang Shang-yi, cựu giám đốc vận hành của TSMC, dẫn dắt. Ông giới thiệu CoWoS lần đầu tiên vào năm 2009 với mục tiêu tăng số lượng bóng bán dẫn trên chip, giải quyết tình trạng tắc nghẽn và tăng hiệu suất. Tuy nhiên, công nghệ này không nhận được sự quan tâm lớn vào thời điểm đó do chi phí cao.
Shang-yi chia sẻ tại Bảo tàng Lịch sử Máy tính ở Mountain View, California năm 2022: “Chúng tôi chỉ có một khách hàng. Tôi thực sự trở thành trò cười cho cả công ty. Rất nhiều áp lực đè nặng lên tôi”.
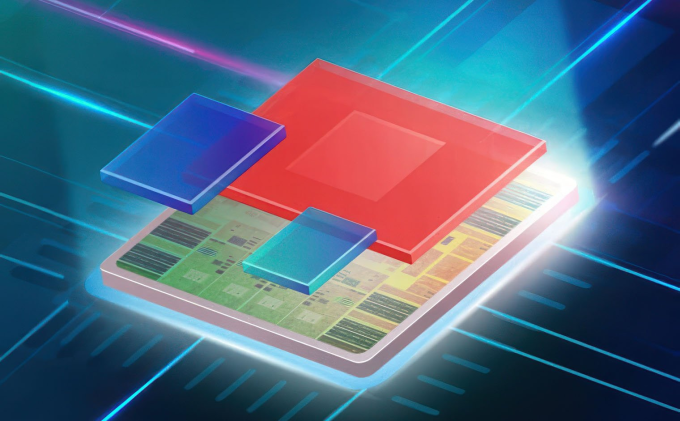
Sự bùng nổ của AI đã thay đổi hoàn toàn cục diện, biến CoWoS trở thành một trong những công nghệ được săn đón nhất. Shang-yi nói với CNN: “Kết quả hiện tại vượt xa mong đợi của tôi”.
Công nghệ này đã phát triển thành nhiều biến thể, mỗi phiên bản được tối ưu hóa cho các nhu cầu hiệu suất tính toán khác nhau. CoWoS-S là phiên bản đầu tiên, sử dụng bộ chuyển đổi silicon hợp nhất hệ thống; CoWoS-R được thiết kế để tăng cường hệ thống tích hợp và hiệu suất; CoWoS-L kết hợp ưu điểm của CoWoS-S và InFO (Integrated Fan-Out) để tăng tốc độ truyền dữ liệu, hiệu quả và tiết kiệm năng lượng.
Ngoài chip AI, CoWoS còn được ứng dụng trong viễn thông và 5G, giúp tăng hiệu suất mạng của thiết bị, cải thiện tốc độ truyền dữ liệu và khả năng xử lý tín hiệu. Nó cũng cho phép tích hợp nhiều thành phần tần số vô tuyến (RF), bộ xử lý tín hiệu (DSP) và tăng tốc độ mạng trên một module nhỏ gọn. Trong lĩnh vực xe tự lái, chip sản xuất trên công nghệ này giúp xử lý lượng lớn dữ liệu cảm biến và đưa ra quyết định theo thời gian thực. Trong điện toán đám mây, CoWoS tạo điều kiện phát triển các giải pháp bảo mật máy chủ cao cấp với hiệu suất tối ưu trên mỗi watt.
Việc TSMC đưa CoWoS sang Mỹ được giới chuyên gia đánh giá là sẽ giúp nước này hoàn thiện hai mảnh ghép quan trọng: chế tạo tiên tiến và đóng gói tiên tiến. Điều này có thể biến Mỹ thành “điểm dừng chân duy nhất” ngoài Đài Loan về sản xuất chip, đồng thời củng cố vị thế của nước này trong lĩnh vực phần cứng AI, mang lại lợi ích cho các khách hàng lớn của TSMC như Apple, Nvidia, AMD, Qualcomm và Broadcom.
Nhà phân tích Eric Chen của Digitimes Research nhận định: “Mảnh ghép này đảm bảo Mỹ có chuỗi cung ứng hoàn chỉnh, từ sản xuất đến đóng gói tiên tiến, mang lại khả năng cạnh tranh của nước này trong lĩnh vực chip AI”.
Về phía TSMC, việc mở rộng sản xuất CoWoS sang Mỹ cũng giúp công ty giảm thiểu rủi ro tiềm ẩn. Nystedt nhận xét: “Thay vì bỏ tất cả trứng vào một giỏ, CoWoS sẽ có mặt ở cả Đài Loan và Mỹ, giúp TSMC cảm thấy an toàn và bảo mật hơn”.
Trong khi đó, các công ty khác như Samsung và Intel cũng đang nghiên cứu các giải pháp đóng gói tiên tiến tương tự CoWoS. Một số hãng Trung Quốc cũng tham gia cuộc đua với các mô hình biến thể CoW+WoS sản xuất trong nước, nhưng năng lực của họ vẫn còn hạn chế.
Admin
Nguồn: VnExpress








